������ڸ����3D-AFM����
��ڸ�����Ҫ���ھ�ϸ��MOSFET�Ƴ��У�����ֱ��ȷ���˹������ȡ���ļ�����״�Ͷ��Ͷȣ��Ӷ�ȷ���˾���ܵĽ��յ����ԡ����õ�CD-SEM��ѧɢ���������OCD������ԭ���ϵļ��ޡ������Ƚ��İ뵼�����ʹ洢���������ϸ���ѭITRS·��ͼ��Ϊ�˿�������̹��ղ�����65nm��45nm�ڵ�ͼ�ε�������״�ߴ磬�����̾�ת������Ƚ���3D����������
�༶�����ÿһ�������S/Dע���λ�á�����ʵ���е�3D�������������Ϳ��Ʋ�ڸ����Ⱥ���״(������ͼ�εײ���)��������Ҫ�ġ�3D-AFM���������Խϸ߾��Ȳ������͵�դ����������������߿����߶ȡ��ھࡢ���ͼ�Ρ���ڽǡ��߱�Ե�ֲڶ�(LER)���߿��仯��(LWV)�Ͳ�ڴֲڶȣ�SWR���������ļ��β�������ϸ˵������1��ͼ1�����⣬��Ҳ��������Ϊ�����ο��ͱ궨�������������߹��տ��ƻ�������
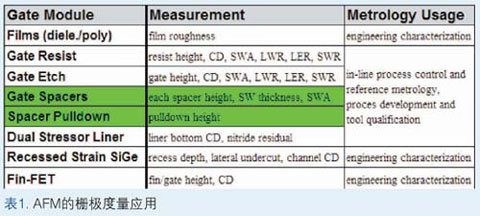
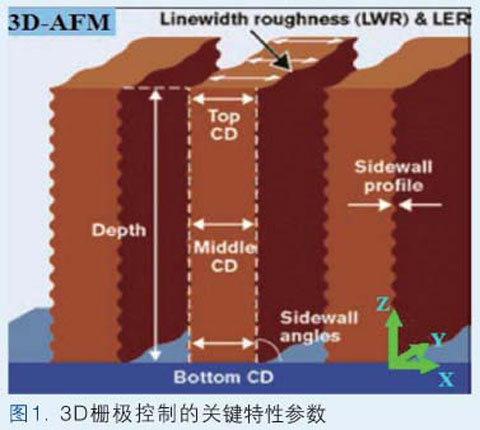
����ͼ�ο���
��ͼ2��ʾ��ÿһ��ڸ�������դ��������ø߶ȸ������Եķ�Ӧ���ӿ�ʴ��RIE���γɵĽ��ʱ�Ĥ�������ṩ���ھ���ܹ���������Դ-©(S/D)�����������ע����Ҫ�ĺ���ƫ�á����������ڼ��������γɺ�ע�벽��佻����С���ڸ������ǡ���ؿ�������ھ����դ����Ե�ĺ���λ�ú����β���ע��Ľ�����������Ҫ�ġ�����������뾧��ܵĽ��յ�����ֱ����صĹ������ȡ���ľ�ȷ������״�Ͷ��Ͷȡ�
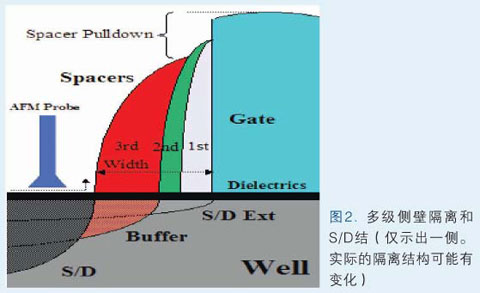
����դ���������ȵ���С��S/D��չ��������Ҫ���٣���ά�ֺͽ�һ����߾���ܵĿ�/�����ܡ����ǣ�����SDE��Ȼ��������Ӿ���ܴ������裨��ͼ����������������������ڶ༶ע�빤�ռ���ö��ָ���ṹ������S/D�ᣬʹ���������ϴ��ͬʱ���־���ܵĵͼ������ݡ�
��ͼ2��ʾ����һ��ƫ�ø�����γ����������SDE���γ�ǰ��pMOS)���(nMOS)�������λ�ע�����ڹ�����֮ǰ��Ȼ�ֱ�Ϊ�ض�ע��Ļ�����S/D�γɵڶ��͵��������롣��ͬ�����̵ľ���ܼ��ɵ�ϸ�ڿ��ܲ�ͬ��������������һ���ġ�
��������ĺ���ߴ�ֱ������dzSDE����������S/D���λ�á���Щ��ȷ���˾���ܵĹؼ�������(��ֵ��ѹ��������������������/©���������ص��ݺͶ�·����ЧӦ)��ͨ������������Ĥ���(CD)��RIE�ӹ�����(CD����״)���Ż�ע�����/����������ʵ����Ҫ��SDE��������S/D��ơ���ˣ���ڸ���CD����״�����Ƿdz��ؼ��ġ���Ҫ����ÿһ�������״�͵ײ����ȣ���ȷ�����μ䡢��Բ�䡢��Բ�����ͼ��ɵ�·(IC)��������ܵ����ܵ�һ���ԡ�
���������������ս
�����ȺͲ����״����Ҫ�Ŀ��Ʋ����������Ⱥ���״�����ر�����ս�ԣ����ڴ�������еı�Ĥ��������(��������X-���ߡ���ѧ����ѧ�͵������ĸ��ּ���)����һ�����⡣��������Ҫ��һ���Բ�ں�ȡ������״���������߶ȵ�����3D�ⶨ����취����2�Ƚ������еĸ��ֳߴ����������
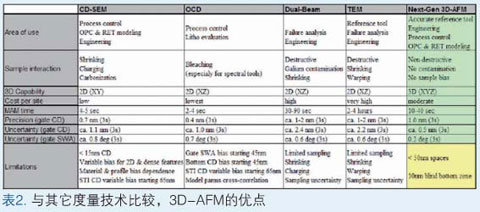
ȱ�ٵ���ά����ֱ������Ϣ��ֹ����CD-SEM�Ը���ײ��������״�ʹ�ֱ�����߶ȵĿɿ�������SEM�����ɾ��硢���ϲ�����ڽ�ЧӦ�����CDƫ�ñ仯��Ӱ�졣
3D-AFM�ܻ�÷��ƻ��Բ����ϵ͵IJ�ȷ���ԡ���ˣ�����������Ϊ������ϵͳ�����������ض���������Ʒ�ľ��Գߴ磬ȷ�������ö����豸����Ʒ����Ʒ��ƫ�ò�ȷ���Է�����Ŀǰ��3D-AFM��ȷ������Ʒ��ص�ƫ�ú��������궨����CD-SEM��OCD��Ψһʵ�÷�����
3D-AFM��������Ʒ���ڽ�ЧӦ��ͼ���ܶ��ء����������н�СCD������ȷ���Եľ���ȷ�ȡ�3D-AFM�ṩ�������Ⱥ�ȷ�ȵķ��ƻ��Բ�����ȫ�Զ����ݷ����ߴ�10-40sec/site�������ʡ���ʹ3D-AFM��Ϊ����غ��̷�����ڸ���������������ߣ����ÿ���OCDģ�ͻ������Բ����X-SEM��TEM������
������ں��
���������ʶ��ͼ����������ϵ�й��ղ�����3D-AFM�ܽ�̽�뾫ȷ������ͬһ��Բ��ͬһ���ϡ�������Ա��AFMɨ��դ����ʴ������դ�������ʴ���ͬһդ�����������ÿһ����CD����״���ݣ�ͼ3��������ͺܷ���ظ����˸����ں�Ⱥ���״�����о���ȷ�ȵ�ֱ�Ӳ�������ʹ�û���������ѧ�������Ʋ����Ҳ�˷���CD-SEM�ڲ�����ڵײ�CD�е����㡣
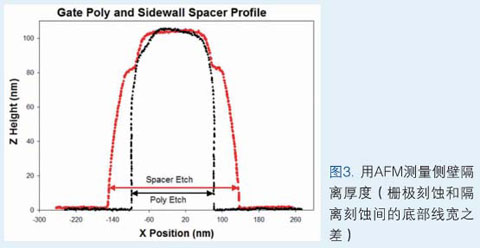
����OCDģ��
65nm�����½ڵ㼼���Ը����ȱ仯���ϸ���ݲ��դ��CD�൱��������OCD���ٶȡ��ɱ��;��ȷ���������ŵ㣬���Ǻܺõĺ�ѡ��������OCD���ݵ�ȷ����ҪУ�顣��ͳ�Ϲ㷺����TEM��Ϊ���ͱ궨��������3D-AFM�DZ�TEM�õ����������У��ͱ궨��ڸ���OCD ģ��ʱ���������ȵ�MU���š����⣬���ܿ��ٶ��ַ��ƻ��Եز��������м�ֵ�����ݡ�

ͼ4����3D-AFM��Ϊ������У��OCDģ�͵Ľ��������OCD��AFM֮������Բ��������Ϊ�����ȷ����Ҫ��OCDģ������һ��������
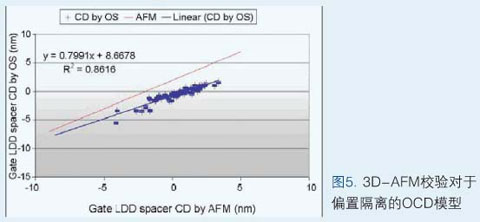
Ϊ��У���һ��ƫ��դ����OCD����������ȷ�ȣ�դ���ײ���CD��3D-AFM�ڸ����ʴ���պ�궨��ͼ5������OCD�ͻ����ݼ�Ĺ�ϵ��������ʾ������0.86��б��0.80������һ��դ���ײ�CD������ƫ��Ϊ-2.8nm���û��ײ�դCD��ȷ����0.95nm(3��)��������TMUΪ0.70nm(3��)���ײ�դCD��OCD��̨�豸���Ⱥ����߾��ȷֱ�Ϊ0.32nm(3��)��0.41nm(3��)����Ӧ��ƫ�ø����ȵ�OCD��̨�豸���Ⱥ����߾��ȷֱ�Ϊ0.17nm(3��)��0.21nm(3��)������ƫ�ø����ʴʱ�ĵײ�դCD���ƣ�OCD�ṩ�˽�Ϊ���������TMU��TMU/T����0.2���Ϳɽ��ܵ�ȷ�ȡ���������루�ڶ������ѵ��ͼ�����״����OS��ģ��˵�ǹ��ڸ����ˡ���ˣ�����SEM���Ƶ���������ʴ���սε�դ�ײ���CD�����ȡ�����70�����ȱ궨λ�ã��ھ�260nm OCD�ṹ����Ƭ�ع����Բ���ڲ���ϵͳ��������Բ����̨����SEM�豸�Ͻ����������ϵIJ�����ͼ6������SEM�ͻ����ݼ�Ĺ�ϵ�����ݱ���������0.99��б��0.99������������ʴʱ�ײ�դCD������ƫ��Ϊ14.2nm��������դ��ʴʱSEMƫ��Ϊ8.8nm�����û����ݲ�ȷ����1.1nm(3��)���� ���� TMUΪ2.1nm(3��)���ײ�դCD��OCD��̨�豸���Ⱥ����߾��ȷֱ�Ϊ0.13nm(3��)��0.20nm(3��)�����ڵ������ڸ�����Ƶ�SEM����TMU/T�ȴ��ڿɽ��ܵ�0.2ˮƽ���¡�3D-AFM���������ǻ��ڼ����ڽ��е��ظ���������ÿһ���������Ĺ��ս�ȷ���ġ�NIST���ٱ�����У��3D-AFM��CD��XYZ�߶ȱ궨��NIST�������Ƕ���������ÿһ�ؼ����սδ���CD�������������ġ������������ؿ�����3D-AFM��ȷ��OCDģ�ͷ�����ʮ�ֳɹ��ġ�
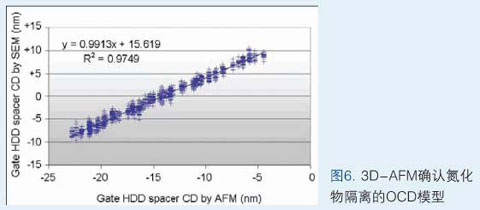
������������������߶�
��������γ�ʱ����������RIE��ʴ��ƽ̹��������ȥ�������ﱡĤ���Ȳ�ڱ���ȥ���ٶȿ죬��դ��������¸��뱡Ĥ���軯���ս���ȫ����¶��դ�缫��Դ/©�����еĹ������γɹ軯�����Ӷ��γɾ���ܵ�ӵ㡣��ڸ����ṩ��դ�����һ�����ȸ��Dz㣬��ֹ�軯�����ǣ���RIE��ʴ���ֵĻ������������������ʧ��������붥������������դ�缫����������ͱ�¶��դ�����սǵIJ�ڡ�
û�и��ǵ�դ���������Ĺ軯���չ����оͻ��γɹ軯�����������Դ/©�軯���դ��ڹ軯��֮��ľ��룬������դ��й©�����Ļ��ᡣ���⣬�軯�������������γɻᵼ��������·����Ҫ�ر��עȷ�ز����Ϳ��Ƶ��������������߶ȣ�NSPD����
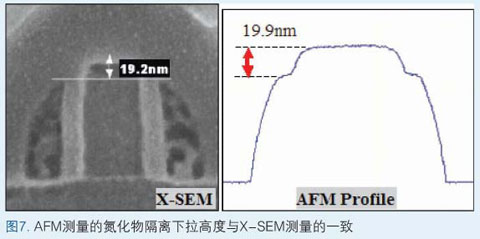
��CD-SEM(����������)��OCD(ģ���в�ȷ��)��ͬ��3D-AFMΪNSPD�߶��ṩ��ֱ�ӡ��ɿ������ƻ��IJ������ֳ�3D-AFM���ݱ���������NSPD���ظ��Կɴ�2nm(3��)��ͼ7˵��X-SEM��3D-AFM�Ե��͵�NSPD�����dz�һ�¡���X-SEM����һ�����洦��������3D-AFM��˵��ͼ7����դ������16��ɨ����(�����)��ƽ��ֵ��ȡ��Щ���ݻ��˲���40�롣�����ӽ�һ��˵����3D-AFM���ṩ���ȡ����С������ȷ���Է���ĺô���
����
��һ��3D-AFM֤�����䵥������������ص������������CD-SEM��OCD��ս�ĸ�����������������Ƚ��ĸ����������̣�3D-AFM��������Ҫ�Ļ�������ػ��������̵Ķ��Թ��ߡ��ر�����Ϊ�����м��м�ֵ�Ļ����ߣ�3D-AFMΪ����TMU��ȷ�Ϻͱ궨����CD-SEM��OCD����ϵͳ���ṩ����ƫ������
����Ķ�:
- ...��ͼ����������DZ��屳��ij��漶��ȫ���Ҫ��
- ...��ʹ���а�ȫ���ϵ�����洢������ȫ������ϵͳ
- ...������ƫ�ò�����Դ������Ľ��½�չ��Ӧ��
- ...�����¿�˹����ijƷ�����ܲ���������������ƪ
- ...�����ߵ���ʽ�¶ȼ��������ϵͳ�����ŵ���ʧ���Ӱ��(��)
- ...�����ߵ���ʽ�¶ȼ��������ϵͳ�����ŵ���ʧ���Ӱ��
- ...��RTD����ϵͳ�����ŵ���ʧ���Ӱ��
- ...������BR/EDR �� Bluetooth Smart��ʮ����Ҫ����
- ...�� ��о���������Уδ�������˻�������ƴ���������ʽ����
- ...�� ̽�صڶ�������ɽӥ�����¡����������鼼����̳��
- ...�� ��2018�й��뵼����̬����ᡱ�ڽ���ʡ��������
- ...�� �������¹滮��CITE 2019�t���ǻ�δ��
- ...�� ��������������TI���ײ������������ڴ�������ܵ�����
- ...�� �ⷨ�뵼�壨ST����Cinemo��Valens��CES 2018չ��������ʾ������Ϣ���ֽ������
- ...�� �������ɵ�·��ҵ���·�չ�߷���̳�����ھ��ٿ�
- ...�� ������ǿ�Ƴ���PCIM����2017չ
- ...�� GPGPU����������й�оƬ��ҵ�Ŀհش�
- ...�� ��������Ʒ�����Wi-Fi���ӵ��ĸ��ؼ�����
- ...�� �������й�MEMS���ܴ�������ҵ��չ��ἴ���ڰ��������Ļ
- ...�� IAICר��������й�о��Ӧ�ô��£���Ϣ��ȫ�߷���̳��������
- ...�� ���ܿ�����Դǯλ����
- ...�� ���5G���ײ�OTA ���Լ���
- ...�� ����г����������ƶ�Molex��ǿ��������ķ�չ
- ...�� �й���ɫ�������˳�������ٿ��ڼ� ����ѧ���ù�̽��ɫ��չ��ģʽ
- ...�� Efinix® ȫ������AI��Ե���㣬�ɹ��Ƴ�Trion™ T20 FPGA��Ʒ, ͬʱ����Ʒ��չ����ʮ������Ԫ��T200 FPGA
- ...�� Ӣ������������ᣬ�����ǻ�������
- ...�� �����Ʒ�������������ֻᱱ������Դר���ɹ�����
- ...�� Manz���ǿƼ�����뵼������ Ϊ��弶�ȳ��ͷ�װ�ṩ��ѧʪ�Ƴ̡�Ϳ��������Ӧ�õ������豸�������
- ...�� �е���BITRODE������ز���ϵͳ˳��������������Դ
- ...�� �е���FTFϵ�е�ز���ϵͳ�б걱������Դ�����ɷ�����˾
- ...�� �е����ʸ�ѹ��Դ����ʽ����ϵͳ�ɹ������е���è
- ...�� �е������ڵ綯�������ؼ������������ֻ��������Ƚ���������








